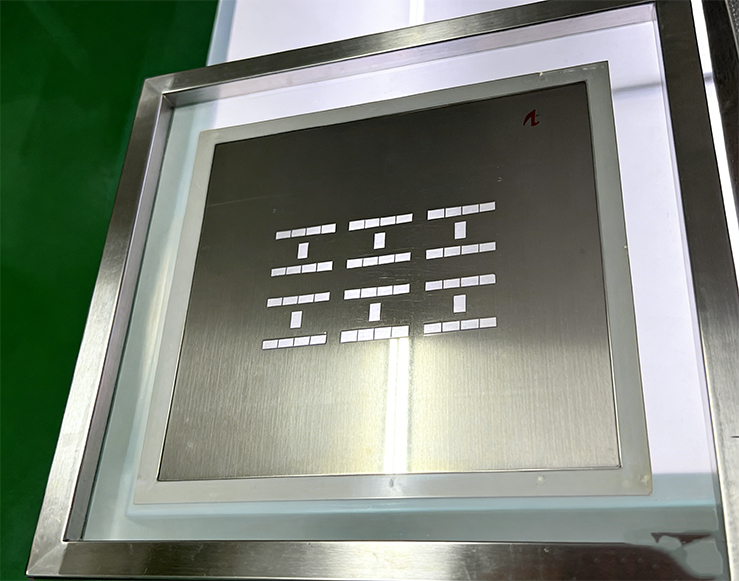
产品简介
电铸 ABF 载板植球掩膜是基于金属电铸微纳加工技术,专为 ABF(Advanced Buffer Layer,先进缓冲层)芯片载板植球工序研发的核心配套部件,是半导体先进封装产业链的关键耗材。ABF 载板作为连接芯片与基板的 “桥梁”,其植球精度直接决定芯片的电气连接可靠性与封装良率,而电铸植球掩膜通过精准复刻纳米级植球孔结构,为 ABF 载板植球提供精准定位基准。该产品选用镍钴合金、高纯镍等高性能金属材质,具备孔位精准、孔壁光滑、耐化学腐蚀、无机械变形等核心优势,可有效规避传统掩膜板存在的孔位偏差、边缘毛刺、易变形等问题,广泛适配高端 ABF 芯片载板的先进封装场景,是推动芯片向高密度、小型化、高可靠性方向发展的重要支撑。
核心特点
纳米级植球定位精准:依托精密电铸与光刻技术融合,植球孔孔径精度可达 ±0.1μm,孔位定位误差≤±0.05μm,最小孔径可至 5μm,完美匹配 ABF 载板超精细间距植球需求,确保植球位置无偏差,筑牢芯片封装基础。
孔壁光滑无毛刺:电铸工艺为非接触式沉积,无机械切削损伤,可实现植球孔壁粗糙度 Ra≤0.05μm,无毛刺、无喇叭口变形,避免植球过程中出现卡球、虚焊、桥连等缺陷,提升植球良率。
无变形稳定性强:采用高纯镍或镍钴合金材质,具备优异的机械强度与稳定性,平面度≤0.01mm,可长期耐受植球过程中的高温、助焊剂侵蚀,无变形、无翘曲,确保 ABF 载板植球时贴合度达标。
耐化学腐蚀耐久性优:材质经过特殊处理,可耐受植球环节中的助焊剂、清洗剂、蚀刻液等多种化学试剂侵蚀,耐腐蚀性测试达 1000 小时以上,使用寿命可达 800 次以上植球循环,大幅降低封装耗材成本。
高密度适配性强:支持孔密度≥2000 孔 /mm² 的高密度布局,可根据 ABF 芯片载板的型号、引脚数量个性化调整植球孔的尺寸、间距、布局,适配 BGA、CSP、FCBGA 等主流先进封装工艺,柔性满足多元封装需求。
实际运用效果
封装良率显著提升:搭载电铸 ABF 载板植球掩膜的 ABF 芯片载板,植球一次良率可达 99.5% 以上,较传统冲压 / 蚀刻掩膜板提升 3%-5%,有效解决植球偏移、虚焊、桥连等高频问题,降低半导体封装的返工率与成本损耗。
芯片电气性能更稳定:精准的植球定位与无缺陷的孔型设计,确保 ABF 载板与芯片引脚之间的连接一致性,减少接触电阻与信号传输损耗,芯片封装后的导通率提升 2%,信号传输稳定性提升 15%,适配高端芯片的高频、高速运行需求。
适配高密度封装需求:可完美支撑 1nm/3nm 先进制程芯片的 ABF 载板植球,实现超精细间距(0.1mm 以下)植球,满足芯片引脚密集化、体积小型化的封装趋势,助力高端 ABF 芯片载板适配手机处理器、AI 芯片、服务器芯片等核心产品。
封装效率与成本优化:自动化植球设备与电铸掩膜板适配性更佳,植球工序效率提升 20%,且掩膜板使用寿命延长 30%,单颗 ABF 芯片载板的封装耗材成本降低 15%,同时减少设备停机维护时间,提升封装产线整体产能。
适配复杂工况封装需求:在高温、高湿的半导体封装车间环境中,掩膜板无变形、无腐蚀失效,可稳定适配大规模量产封装场景,批量生产的 ABF 载板植球一致性≥99.8%,满足半导体封装的规模化、标准化需求。
应用领域
高端消费电子芯片封装:适配手机 AP 芯片、电脑 CPU、GPU 等高端消费电子 ABF 芯片载板,通过高精度植球掩膜保障芯片封装可靠性,支撑消费电子的高性能、小型化发展。
人工智能 / 服务器芯片封装:用于 AI 训练芯片、数据中心服务器芯片的 ABF 载板封装,满足芯片高密度、高算力的封装需求,为 AI 算力提升与服务器稳定性提供核心支撑。
汽车电子芯片封装:适配车载自动驾驶芯片、车规级功率芯片的 ABF 载板,植球掩膜的高稳定性、抗腐蚀特性,可满足汽车电子的高温、抗振动等严苛封装工况。
通信芯片封装:应用于 5G/6G 通信芯片、射频芯片的 ABF 载板封装,精准的植球定位保障芯片信号传输稳定性,助力通信设备的高速、低损耗通信需求。
半导体先进封装量产:适配半导体封装厂的大规模 ABF 载板植球量产产线,提供高一致性、高耐久性的电铸植球掩膜配套服务,推动先进封装产业规模化发展。
联系人:赖先生
手 机:18938693450
邮 箱:yw9@zldsmt.com
公 司:深圳市卓力达电子有限公司
地 址:深圳市宝安区福永镇新和村福园一路华发工业园A3栋